
利用光线透过光罩照射在感光材料上,再以溶剂浸泡将感光材料受光照射到的部份加以溶解或保留,如此所形成的光阻图案会和光罩完全相同或呈互补。由于微影制程的环境是采用黄光照明而非一般摄影暗房的红光,所以这一部份的制程常被简称为“黄光”。微影制程很好地实现了黄光工艺触摸屏视觉上的精准度。

此种电容屏有助于手机在超窄边框上面布线,使手机工艺如钟表般精细,更薄,身材更漂亮,更有利于超窄边款手机的散热,更是贴合技术的绝配。
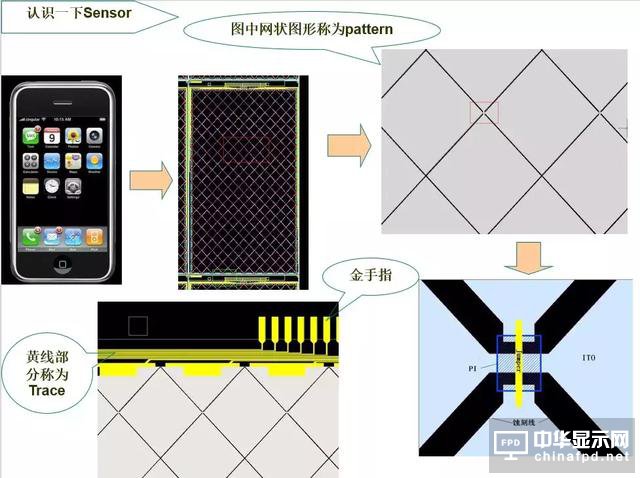
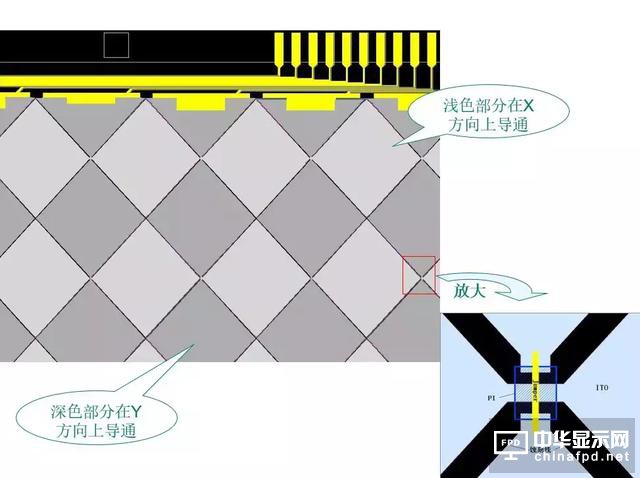

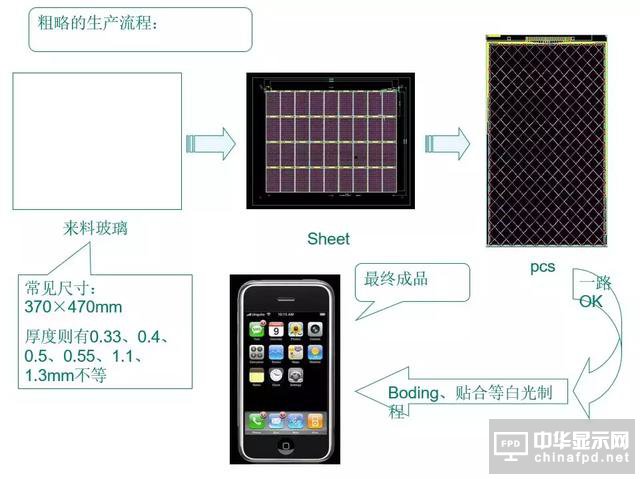
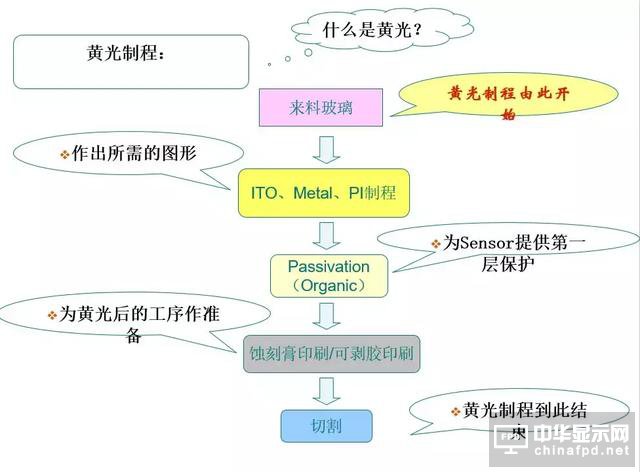
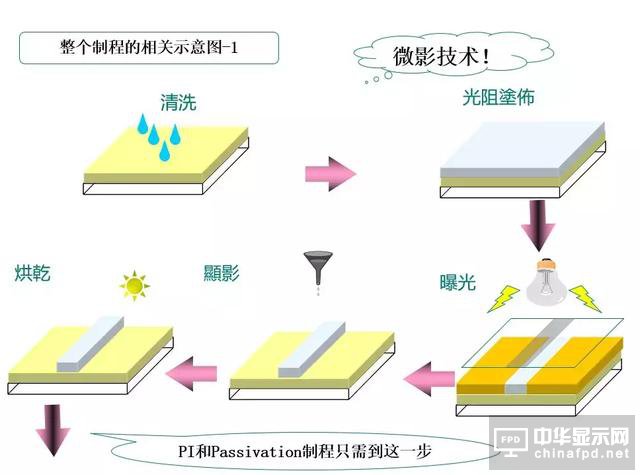
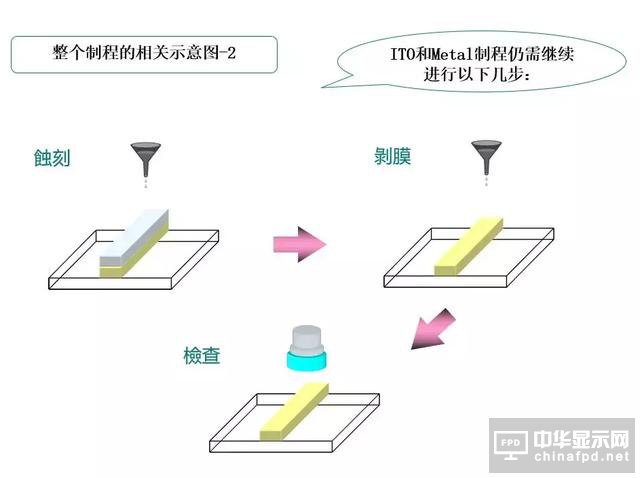
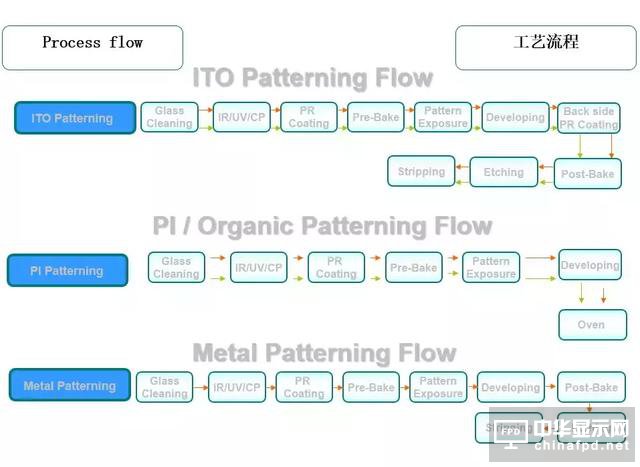
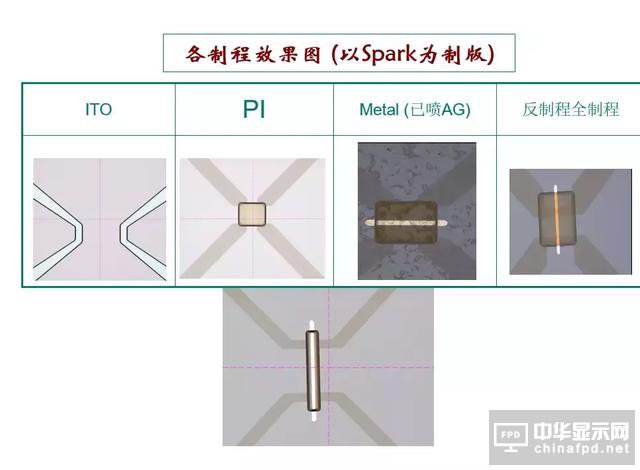
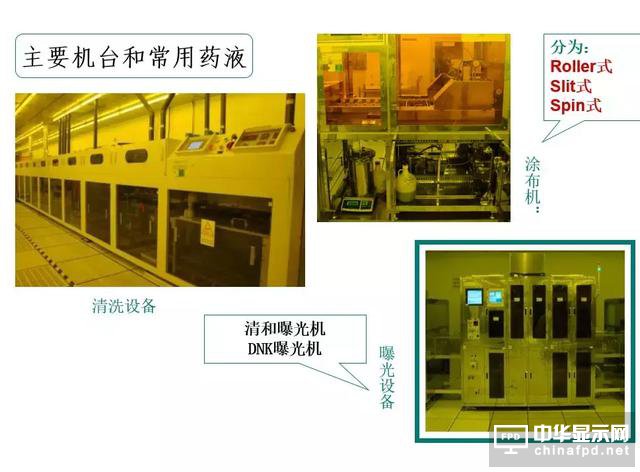

黄光制程百问百答
1、PHOTO 流程?
答:上光阻→曝光→显影→显影后检查→CD量测→Overlay量测
2、何为光阻?其功能为何?其分为哪两种?
答:Photoresist(光阻).是一种感光的物质,其作用是将Pattern从光罩(Reticle)上传递到Wafer上的一种介质。其分为正光阻和负光阻。
3、何为正光阻?
答:正光阻,是光阻的一种,这种光阻的特性是将其曝光之后,感光部分的性质会改变,并在之后的显影过程中被曝光的部分被去除。
4、何为负光阻?
答:负光阻也是光阻的一种类型,将其曝光之后,感光部分的性质被改变,但是这种光阻的特性与正光阻的特性刚好相反,其感光部分在将来的显影过程中会被留下,而没有被感光的部分则被显影过程去除。
5、什幺是曝光?什幺是显影?
答:曝光就是通过光照射光阻,使其感光;显影就是将曝光完成后的图形处理,以将图形清晰的显现出来的过程。
6、何谓 Photo?
答:Photo=Photolithgraphy,光刻,将图形从光罩上成象到光阻上的过程。
7、Photo主要流程为何?
答:Photo的流程分为前处理,上光阻,Soft Bake, 曝光,PEB,显影,Hard Bake等。
8、何谓PHOTO区之前处理?
答:在Wafer上涂布光阻之前,需要先对Wafer表面进行一系列的处理工作,以使光阻能在后面的涂布过程中能够被更可靠的涂布。前处理主要包括Bake,HDMS等过程。其中通过Bake将Wafer表面吸收的水分去除,然后进行HDMS工作,以使Wafer表面更容易与光阻结合。
9、何谓上光阻?
答:上光阻是为了在Wafer表面得到厚度均匀的光阻薄膜。光阻通过喷嘴(Nozzle)被喷涂在高速旋转的Wafer表面,并在离心力的作用下被均匀的涂布在Wafer的表面。
10、何谓Soft Bake?
答:上完光阻之后,要进行Soft Bake,其主要目的是通过Soft Bake将光阻中的溶剂蒸发,并控制光阻的敏感度和将来的线宽,同时也将光阻中的残余内应力释放。
11、何谓曝光?
答:曝光是将涂布在Wafer表面的光阻感光的过程,同时将光罩上的图形传递到Wafer上的过程。
12、何谓PEB(Post Exposure Bake)?
答:PEB是在曝光结束后对光阻进行控制精密的Bake的过程。其目的在于使被曝光的光阻进行充分的化学反应,以使被曝光的图形均匀化。
13、何谓显影?
答:显影类似于洗照片,是将曝光完成的Wafer进行成象的过程,通过这个过程,成象在光阻上的图形被显现出来。
14、何谓Hard Bake?
答:Hard Bake是通过烘烤使显影完成后残留在Wafer上的显影液蒸发,并且固化显影完成之后的光阻的图形的过程。
15、何为BARC?何为TARC?它们分别的作用是什幺?
答:BARC=Bottom Anti Reflective Coating, TARC=Top Anti Reflective Coating. BARC是被涂布在光阻下面的一层减少光的反射的物质,TARC则是被涂布在光阻上表面的一层减少光的反射的物质。他们的作用分别是减少曝光过程中光在光阻的上下表面的反射,以使曝光的大部分能量都被光阻吸收。
16、何谓 Iline?
答:曝光过程中用到的光,由Mercury Lamp(汞灯)产生,其波长为365nm,其波长较长,因此曝光完成后图形的分辨率较差,可应用在次重要的层次。
17、何谓 DUV?
答:曝光过程中用到的光,其波长为248nm,其波长较短,因此曝光完成后的图形分辨率较好,用于较为重要的制程中。
18、I-line与DUV主要不同处为何?
答:光源不同,波长不同,因此应用的场合也不同。I-Line主要用在较落后的制程(0.35微米以上)或者较先进制程(0.35微米以下)的Non-Critical layer。DUV则用在先进制程的Critical layer上。#p#分页标题#e#
19、何为Exposure Field?
答:曝光区域,一次曝光所能覆盖的区域
20、何谓 Stepper? 其功能为何?
答:一种曝光机,其曝光动作为Step by step形式,一次曝整个exposure field,一个一个曝过去
21、何谓 Scanner? 其功能为何?
答:一种曝光机,其曝光动作为Scanning and step形式, 在一个exposure field曝光时, 先Scan完整个field, Scan完后再移到下一个field.
22、何为象差?
答:代表透镜成象的能力,越小越好.
23、Scanner比Stepper优点为何?
答:Exposure Field大,象差较小
24、曝光最重要的两个参数是什幺?
答:Energy(曝光量), Focus(焦距)。如果能量和焦距调整的不好,就不能得到要求的分辨率和要求大小的图形,主要表现在图形的CD值超出要求的范围。因此要求在生产时要时刻维持最佳的能量和焦距,这两个参数对于不同的产品会有不同。
25、何为Reticle?
答:Reticle也称为Mask,翻译做光掩模板或者光罩,曝光过程中的原始图形的载体,通过曝光过程,这些图形的信息将被传递到芯片上。
26、何为Pellicle?
答:Pellicle是Reticle上为了防止灰尘(dust)或者微尘粒子(Particle)落在光罩的图形面上的一层保护膜。
27、何为OPC光罩?
答:OPC (Optical Proximity Correction)为了增加曝光图案的真实性,做了一些修正的光罩,例如,0.18微米以下的Poly, Metal layer就是OPC光罩。
28、何为PSM光罩?
答:PSM (Phase Shift Mask)不同于Cr mask, 利用相位干涉原理成象,目前大都应用在contact layer以及较小CD的Critical layer(如AA,POLY,METAL1)以增加图形的分辨率。
29、何为CR Mask?
答:传统的铬膜光罩,只是利用光讯0与1干涉成像,主要应用在较不Critical 的layer
30、光罩编号各位代码都代表什幺?
答:例如003700-156AA-1DA, 0037代表产品号,00代表Special code,156代表layer,A代表客户版本,后一个A代表SMIC版本,1代表FAB1,D代表DUV(如果是J,则代表I-line),A代表ASML机台(如果是C,则代表Canon机台)
31、光罩室同时不能超过多少人在其中?
答:2人,为了避免产生更多的Particle和静电而损坏光罩。
32、存取光罩的基本原则是什幺?
答:(1) 光罩盒打开的情况下,不准进出Mask Room,最多只准保持2个人(2) 戴上手套(3) 轻拿轻放
33、如何避免静电破坏Mask?
答:光罩夹子上连一导线到金属桌面,可以将产生的静电导出。
34、光罩POD和FOUP能放在一起吗?它们之间至少应该保持多远距离?
答:不能放在一起,之间至少要有30公分的距离,防止搬动FOUP时碰撞光罩Pod而损坏光罩。
35、何谓 Track?
答:Photo制程中一系列步骤的组合,其包括:Wafer的前、后处理,Coating(上光阻),和Develop(显影)等过程。
36、In-line Track机台有几个Coater槽,几个Developer槽?
答:均为4个
37、机台上亮红灯的处理流程?
答:机台上红灯亮起的时候表明机台处于异常状态,此时已经不能RUN货,因此应该及时Call E.E进行处理。若EE现在无法立即解决,则将机台挂DOWN。
38、何谓 WEE? 其功能为何?
答:Wafer Edge Exposure。由于Wafer边缘的光阻通常会涂布的不均匀,因此一般不能得到较好的图形,而且有时还会因此造成光阻peeling而影响其它部分的图形,因此 将Wafer Edge的光阻曝光,进而在显影的时候将其去除,这样便可以消除影响。
39、何为PEB?其功能为何?
答:Post Exposure Bake,其功能在于可以得到质量较好的图形。(消除standing waves)
40、PHOTO POLYIMIDE所用的光阻是正光阻还是负光阻
答:目前正负光阻都有,SMIC FAB内用的为负光阻。
41、RUN货结束后如何判断是否有wafer被reject?
答:查看RUN之前lot里有多少Wafer,再看Run之后lot里的WAFER是否有少掉,如果有少,则进一步查看机台是否有Reject记录。
42、何谓 Overlay? 其功能为何?
答:迭对测量仪。由于集成电路是由很多层电路重迭组成的,因此必须保证每一层与前面或者后面的层的对准精度,如果对准精度超出要求范围内,则可能造成整个电路不能完成设计的工作。因此在每一层的制作的过程中,要对其与前层的对准精度进行测量,如果测量值超出要求,则必须采取相应措施调整process condition.
43、何谓 ADI CD?
答:Critical Dimension,光罩图案中最小的线宽。曝光过后,它的图形也被复制在Wafer上,通常如果这些最小的线宽能够成功的成象,同时曝光的其它的图形也能够成功的成象。因此通常测量CD的值来确定process的条件是否合适。
44、何谓 CD-SEM? 其功能为何?
答:扫描电子显微镜。是一种测量用的仪器,通常可以用于测量CD以及观察图案。
45、PRS的制程目的为何?
答:PRS (Process Release Standard)通过选择不同的条件(能量和焦距)对Wafer曝光,以选择最佳的process condition。
46、何为ADI?ADI需检查的项目有哪些?
答:After Develop Inspection,曝光和显影完成之后,通过ADI机台对所产生的图形的定性检查,看其是否正常,其检查项目包括:Layer ID,Locking Corner,Vernier,Photo Macro Defect
47、何为OOC, OOS,OCAP?
答:OOC=out of control,OOS=Out of Spec,OCAP=out of control action plan
48、当需要追货的时候,是否需要将ETCH没有下机台的货追回来?
答:需要。因为通常是process出现了异常,而且影响到了一些货,因此为了减少损失,必须把还没有ETCH的货追回来,否则ETCH之后就无法挽回损失。
49、PHOTO ADI、PHOTO OVERLAY检查的SITE是每片几个点?PHOTO ADI检查的片数一般是哪几片?
答:PHOTO ADI检查的SITE是5点,Wafer中间一点,周围四点。PHOTO OVERLAY检查的SITE是每片20点。PHOTO ADI检查的片数一般是#1,#6,#15,#24; 统计随机的考虑。
50、半导体中一般金属导线材质为何?
答:鵭线(W)/铝线(Al)/铜线(Cu)
51、何谓RTMS,其主要功能是什幺?
答:RTMS (Reticle Management System) 光罩管理系统用于trace光罩的History,Status,Location,and Information以便于光罩管理
52、PHOTO区的主机台进行PM的周期?#p#分页标题#e#
答:一周一次
53、PHOTO区的控片主要有几种类型?
答:
(1) Particle :作为Particle monitor用的芯片,使用前测前需小于10颗
(2) Chuck Particle :作为Scanner测试Chuck平坦度的专用芯片,其平坦度要求非常高
(3) Focus :作为Scanner Daily monitor best 的wafer
(4) CD :做为photo区daily monitor CD稳定度的wafer
(5) PR thickness :做为光阻厚度测量的wafer
(6) PDM :做为photo defect monitor的wafer
54、当TRACK刚显示光阻用完时,其实机台中还有光阻吗?
答:有少量光阻
55、何谓电浆 Plasma?
答:电浆是物质的第四状态.带有正,负电荷及中性粒子之总和;其中包含电子,正离子,负离子,中性分子,活性基及发散光子等,产生电浆的方法可使用高温或高电压.
56、Asher机台进行蚀刻最关键之参数为何?
答:温度
57、光刻部的主要机台是什幺? 它们的作用是什幺?
答:光刻部的主要机台是: TRACK(涂胶显影机), Sanner(扫描曝光机)
58、为什幺说光刻技术最象日常生活中的照相技术
答:Track 把光刻胶涂附到芯片上就等同于底片,而曝光机就是一台最高级的照相机. 光罩上的电路图形就是"人物". 通过对准,对焦,打开快门, 让一定量的光照过光罩, 其图像呈现在芯片的光刻胶上, 曝光后的芯片被送回Track 的显影槽, 被显影液浸泡, 曝光的光刻胶被洗掉, 图形就显现出来了.
59、何谓反射功率?
答:蚀刻过程中,所施予之功率并不会完全地被反应腔内接收端所接受,会有部份值反射掉,此反射之量,称为反射功率
60、常听说的.18 或点13 技术是指什幺?
答:它是指某个产品,它的最小"CD" 的大小为0.18um or 0.13um. 越小集成度可以越高, 每个芯片上可做的芯片数量越多, 难度也越大.它是代表工艺水平的重要参数.
61、从点18工艺到点13 工艺到点零9. 难度在哪里?
答:难度在光刻部, 因为图形越来越小, 曝光机分辨率有限.
62、曝光机的NA 是什幺?
答:NA是曝光机的透镜的数值孔径;是光罩对透镜张开的角度的正玹值. 最大是1; 先进的曝光机的NA 在0.5 ---0.85之间.
63、曝光机分辨率是由哪些参数决定的?
答:分辨率=k1*Lamda/NA. Lamda是用于曝光的光波长;NA是曝光机的透镜的数值孔径; k1是标志工艺水准的参数。
64、如何提高曝光机的分辨率呢?
答:减短曝光的光波长, 选择新的光源; 把透镜做大,提高NA.
65、为什幺光刻区采用黄光照明?
答:因为白光中包含365nm成份会使光阻曝光,所以采用黄光; 就象洗像的暗房采用暗红光照明.
66、何谓湿式蚀刻和干式蚀刻
答:湿式蚀刻:利用液相的酸液或溶剂;将不要的薄膜去除。干式蚀刻:利用plasma将不要的薄膜去除。
67、如何做Overlay 测量呢?
答:芯片(Wafer)被送进Overlay 机台中. 先确定Wafer的位置从而找到Overlay MARK. 这个MARK 是一个方块 IN 方块的结构.大方块是前层, 小方块是当层;通过小方块是否在大方块中心来确定Overlay的好坏.
68、生产线上最贵的机器是什幺
答:曝光机;
69、曝光机贵在哪里?
答:曝光机贵在它的光学成像系统
70、在WAFER 上, 什幺叫一个Field?
答:光罩上图形成象在WAFER上, 最大只有26X33mm一块(这一块就叫一个Field),激光工作台把WAFER 移动一个Field的位置,再曝一次光,再移动再曝光。 直到覆盖整片WAFER。 所以,一片WAFER 上有约100左右Field.
71、什幺叫一个Die?
答:一个Die也叫一个Chip;它是一个功能完整的芯片。 一个Field可包含多个Die;
72、为什幺曝光机的绰号是“印钞机”
答:曝光机 很贵;一天的折旧有好几万人民币之多;所以必须充份利用它的产能。
73、Track和Scanner内主要使用什幺手段传递Wafer
答:机器人手臂(robot), Scanner 的ROBOT 有真空(VACCUM)来吸住WAFER. TRACK的ROBOT 设计独特, 用边缘HOLD WAFER.
74、可否用肉眼直接观察测量Scanner曝光光源输出的光?
答:绝对禁止;强光对眼睛会有伤害
75、为什幺黄光区内只有Scanner应用Foundation(底座)
答:Scanner曝光对稳定性有极高要求(减震)
76、近代光刻技术分哪几个阶段?
答:从80’S 至今可分4阶段:它是由曝光光源波长划分的;高压水银灯的G-line(438nm), I-line(365nm); excimer laser KrF(248nm), ArF laser(193nm)
77、如何做CD 测量呢?
答:芯片(Wafer)被送进CD SEM 中. 电子束扫过光阻图形(Pattern).有光阻的地方和无光阻的地方产生的二次电子数量不同; 处理此信号可的图像.对图像进行测量得CD.
78、什幺是DOF
答:DOF 也叫Depth Of Focus, 与照相中所说的景深相似. 光罩上图形会在透镜的另一侧的某个平面成像, 我们称之为像平面(Image Plan), 只有将像平面与光阻平面重合(In Focus)才能印出清晰图形. 当离开一段距离后, 图像模糊. 这一可清晰成像的距离叫DOF
79、曝光显影后产生的光阻图形(Pattern)的作用是什幺?
答:曝光显影后产生的光阻图形有两个作用:一是作刻蚀的模板,未盖有光阻的地方与刻蚀气体反应,被吃掉.去除光阻后,就会有电路图形留在芯片上.另一作用是充当例子注入的模板.
80、光阻种类有多少?
答:光阻种类有很多.可根据它所适用的曝光波长分为I-line光阻,KrF光阻和ArF光阻。
81、Scanner在曝光中可以达到精确度宏观理解:
答:Scanner 是一个集机,光,电为一体的高精密机器;为控制iverlay<40nm,在曝光过程中,光罩和Wafer的运动要保持很高的同步性.在250nm/秒的扫描曝光时,两者同步位置<10nm.相当于两架时速1000公里/小时的波音747飞机前后飞行,相距小于10微米
82、光罩的结构如何?
答:光罩是一块石英玻璃,它的一面镀有一层铬膜(不透光).在制造光罩时,用电子束或激光在铬膜上写上电路图形(把部分铬膜刻掉,透光).在距铬膜5mm 的地方覆盖一极薄的透明膜(叫pellicle),保护铬膜不受外界污染.
83、在超净室(cleanroom)为什幺不能携带普通纸
答:普通纸张是由大量短纤维压制而成,磨擦或撕割都会产生大量微小尘埃(particle).进cleanroom 要带专用的Cleanroom Paper.
84、光阻层的厚度大约为多少?#p#分页标题#e#
答:光阻层的厚度与光阻种类有关.I-line光阻最厚。
85、哪些因素影响光阻厚度?
答:光阻厚度与芯片(WAFER)的旋转速度有关,越快越薄,与光阻粘稠度有关.
86、哪些因素影响光阻厚度的均匀度?
答:光阻厚度均匀度与芯片(WAFER)的旋转加速度有关,越快越均匀,与旋转加减速的时间点有关.
87、金属蚀刻后为何不可使用一般硫酸槽进行清洗?
答:因为金属线会溶于硫酸中
88、根据工艺需求排气分几个系统?
答:分为一般排气(General)、酸性排气(Scrubbers)、碱性排气(Ammonia)和有机排气(Solvent) 四个系统。
89、高架 地板分有孔和无孔作用?
答:使循环空气能流通 ,不起尘,保证洁净房内的洁净度; 防静电;便于HOOK-UP。
90、离子发射系统作用
答:离子发射系统,防止静电
91、什幺是制程工艺真空系统(PV)
答:是提供厂区无尘室生产及测试机台在制造过程中所需的工艺真空;如真空吸笔、光阻液涂布、吸芯片用真空源等。该系统提供一定的真空压力(真空度大于 80 kpa)和流量,每天24小时运行
92、House Vacuum System 作用
答:HV(House Vacuum)系统提供洁净室制程区及回风区清洁吸取微尘粒子之真空源,其真空度较低。使用方法为利用软管连接事先已安装在高架地板下或柱子内的真空吸孔,打开运转电源。此系统之运用可减低清洁时的污染。
93、Filter Fan Unit System(FFU)作用和Clean Room 洁净室系统
答:FFU系统保证洁净室内一定的风速和洁净度,由Fan和Filter(ULPA)组成。洁净室系统供应给制程及机台设备所需之洁净度、温度、湿度、正压、气流条件等环境要求。
94、工程师在正常跑货用纯水做rinse或做机台维护时,要注意不能有酸或有机溶剂(如IPA等)进入纯水回收系统中,这是因为:
答:酸会导致conductivity(导电率)升高,有机溶剂会导致TOC升高。两者均会影响并降低纯水回收率。
95、若在Fab 内发现地面有水滴或残留水等,应如何处理或通报?若机台内的drain管有接错或排放成分分类有误,将会导致后端的主系统出现什幺问题?
答:先检查是否为机台漏水或做PM所致,若为厂务系统则通知厂务中控室。机台内的drain管有接错或排放成分分类有误将会导致后端处理的主系统相关指标处理不合格,从而可能导致公司排放口超标排放的事故。
96、当机台用到何种气体时,须安装气体侦测器?
答:PH3
97、蚀刻对象依薄膜种类可分为:
答:poly,oxide, metal
98、何谓蚀刻(Etch)?
答:将形成在晶圆表面上的薄膜全部,或特定处所去除至必要厚度的制程。
蚀刻种类:(1) 干蚀刻(2) 湿蚀刻
99、AEI目检Wafer须检查哪些项目:
答:(1) 正面颜色是否异常及刮伤 (2) 有无缺角及Particle (3)刻号是否正确
100、名词解释:
热交换器(HEAT EXCHANGER):将热能经由介媒传输,以达到温度控制之目地
AEI:After Etching Inspection 蚀刻后的检查
金属蚀刻机台asher:去光阻及防止腐蚀
UV curing:利用UV光对光阻进行预处理以加强光阻的强度
Over-etching(过蚀刻 ):蚀刻过多造成底层被破坏
Etch rate(蚀刻速率):单位时间内可去除的蚀刻材料厚度或深度
Seasoning(陈化处理):是在蚀刻室的清净或更换零件后,为要稳定制程条件,使用仿真(dummy) 晶圆进行数次的蚀刻循环。
Spin Dryer:利用离心力将晶圆表面的水份去除
Maragoni Dryer:利用表面张力将晶圆表面的水份去除
IPA Vapor Dryer:利用IPA(异丙醇)和水共溶原理将晶圆表面的水份去除
Asher的主要用途::光阻去除
Wet bench dryer 功用:将晶圆表面的水份去除
SEM:扫描电子显微镜(Scan Electronic Microscope)光刻部常用的也称道CD SEM. 用它来测量CD
BACKSIDE HELIUM COOLING:藉由氦气之良好之热传导特性,能将芯片上之温度均匀化
ORIENTER :搜寻notch边,使芯片进反应腔的位置都固定,可追踪问题
EPD:侦测蚀刻终点;End point detector利用波长侦测蚀刻终点
MFC:mass flow controler气体流量控制器;用于控制 反应气体的流量
GDP:气体分配盘(gas distribution plate)
isotropic etch:等向性蚀刻;侧壁侧向蚀刻的机率均等
anisotropic etch:非等向性蚀刻;侧壁侧向蚀刻的机率少
etch :不同材质之蚀刻率比值
AEI CD:蚀刻后特定图形尺寸之大小,特征尺寸(Critical Dimension)
CD bias:蚀刻CD减蚀刻前黄光CD
关注我们

公众号:china_tp
微信名称:亚威资讯
显示行业顶级新媒体
扫一扫即可关注我们